在铝薄膜的晶界中,已经可以观察到由电迁移所诱导的晶界迁移现象。我们现在将讨论在各向异性导体白锡的晶界处的电迁移现象,并且证明电迁移会导致沿着晶界平面的原子通量的产生。以下参考数据为锡沿着这两个方向的扩散率和电阻率:图8.15理想状态下的两个白锡晶粒之间的晶界的简单几何示意在电迁移下的原子的扩散通量方向应当和电子流动方向相同。......
2025-09-29
图9.11所示为无铅焊料凸点第一横截面,图9.11(a)~(d)分别是在电迁移试验前,与实验20 h、110 h、200 h之后的情况,温度为120℃,实验电流大小为1.5 A。电子流动方向为从镍UBM层到铜凸点焊盘。实验200 h后,在阴极有孔洞生成[图9.11(d)]。其孔洞形成过程比在9.4.1节中我们讨论过的共晶锡铅焊料要慢得多。但是,在阳极的金属间化合物被挤压成了小丘状。相比之下,共晶锡铅焊料在电迁移过程中,没有化合物被挤压出来。
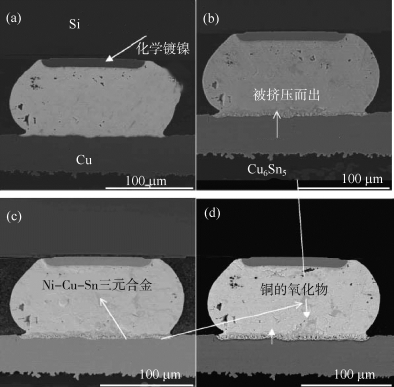
图9.11 无铅焊料凸点第一横截面
(a)实验前;(b)实验20 h后;(c)实验110 h后;(d)实验200 h后
图9.12所示为标记物a和标记物b在横截面上的运动。其标记物移动量远少于共晶锡铅焊料中的标记物的移动量。在焊料底部区域的标记物移动量更多(4号和5号标记物),它们比较接近被挤压出的金属间化合物。然而,接近化学镀镍UBM层的编号为1号~3号的标记物移动量很小。和共晶锡铅焊料相比,标记物在SnAg3.8 Cu0.7中的移动量要小得多,这表明后者的电迁移过程进行得比前者慢。
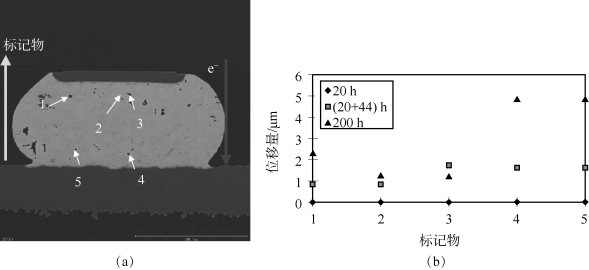 (https://www.chuimin.cn)
(https://www.chuimin.cn)
图9.12 标记物位置及位移量
(a)标记物位置;(b)标记物在无铅焊料焊点的一个横截面表面的移动量
样品在垂直于第一横截面的方向进行了第二次横切,图9.13所示为其SEM照片。在阴极处可以观察到孔洞的形成和镍基UBM层的溶解。然而,第一横截面显得很平坦,没有出现明显的凹陷或鼓包。在焊料基体中发现了镍铜锡三元合金化合物(在显微图中颜色较深),这一点与共晶锡铅焊料类似。在电迁移的过程中,该合金生长并穿透了焊料凸点的整个横截面。距化学镀镍UBM层最远的合金,其距离为90μm,几乎到达了铜的阳极处。
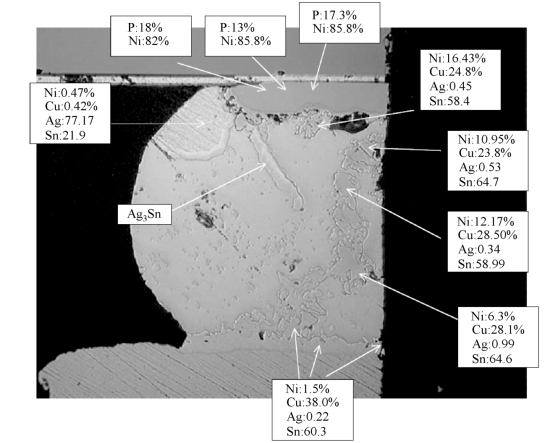
图9.13 无铅焊料焊点的第二横截面的SEM照片
(图中分数均为原子百分数)
相关文章

在铝薄膜的晶界中,已经可以观察到由电迁移所诱导的晶界迁移现象。我们现在将讨论在各向异性导体白锡的晶界处的电迁移现象,并且证明电迁移会导致沿着晶界平面的原子通量的产生。以下参考数据为锡沿着这两个方向的扩散率和电阻率:图8.15理想状态下的两个白锡晶粒之间的晶界的简单几何示意在电迁移下的原子的扩散通量方向应当和电子流动方向相同。......
2025-09-29

铝薄膜互连线,需要至少在绝对温度达到1/2的熔点时开始产生电迁移现象。换句话讲,如果物质的浓度场是无源场的话,原子和空位的扩散通量将会均匀分布,则在互连线中也不会发生电迁移现象。如果在某个区域中,它们的分布是十分均匀的,则会有电迁移现象的发生,但并不会有电迁移所导致的损伤出现,其本质原因是其场量是无源的。在接下来的内容中,我们将接着分别讨论微观结构、溶质原子和应力对于焊点的电迁移现象的影响作用。......
2025-09-29

焦耳热不仅会增加焊料凸点的温度,从而增加电迁移速率,还可能在焊料凸点上产生小的温度差,从而导致热迁移。热迁移将在第12章中讨论。焊料接头中另一个非常独特和重要的电迁移行为是它有两个反应界面。图1.16所示为阴极接触界面处电迁移导致的失效的SEM横截面照片,其中额定电流密度约为2×104 A/cm2,试验温度为100℃。图1.16一组由倒装芯片焊料接头阴极处的电流拥挤造成的14μm厚的金属Cu的UBM层溶解导致的电迁移失效SEM照片......
2025-09-29

图6.1所示为锡铜共晶镀层上较长锡须的一张放大的SEM照片,该图中的锡须是长直状的,且其表面为沟槽状。图6.2所示为由聚焦离子束制得的锡铜焊料与铜界面处的高倍率照片。对于锡须生长而言,锡铜共晶焊料与纯锡焊料镀层之间最大的区别在于在晶界处是否存在Cu6Sn5析出相。图6.3垂直于晶须长度方向的锡须横截面TEM照片及[0 0 1]方向的电子衍射花样......
2025-09-29

是假想电荷数,它所表示的是电子与扩散原子之间动量交换的力的等效效果;eE是电子风力,在良导体中通常它是直接力的十倍左右,在金属的电迁移现象中电子风力的作用要远大于直接力。所以,在电迁移现象中,被增强的原子扩散通量方向通常与电子漂移通量方向一致。换句话说,它将会体验到更大的电子散射作用,以及更大的电子风产生的力的作用,从而将其推向下一个平衡位置,即该原子扩散前空位所在位置。......
2025-09-29

而其中,倒装芯片焊点尺寸设计和焊料接头的材料选择取决于器件的具体应用和器件设计者所提供的规范。另外,至今还没有任何关于倒装芯片焊料接头电迁移测试的行业标准,而这些标准的建立将会给设计工作提供很大的帮助。鉴于倒装芯片焊料接头的设计细节和选择规则已超出了本书的范围,本书仅提供一些关于焊料接头可靠性问题的基本理解,从而使设计师在其电路设计中考虑到这些问题。......
2025-09-29

图1.4为将硅芯片和引线框架互连的引线键合示意。通常,倒装芯片技术的优点是封装尺寸小,I/O引脚数量大,性能好。倒装芯片互连技术已经在大型计算机中使用了30多年。倒装芯片焊料接头的横截面示意如图1.9所示。芯片上的焊料凸点采用蒸发技术进行沉积并通过刻蚀技术进行图案化获得,目前采用选择性电镀沉积法进行制备。BLM控制着固定体积焊球熔化时的高度,这是所谓“可控塌陷芯片互连”中“可控”的含义。......
2025-09-29

人们为了测定铝条带电迁移中的背应力已经付出了大量努力。电迁移测试是在260℃的温度下进行的。稳态下电阻增长速率δ/δt,和稳态下电迁移所引起的压应力梯度δσEM/δx,与电流密度的函数关系如图8.9所示。如果在铜的大马士革结构中,能够通过表面扩散机制引发电迁移,那么在结构体内,我们需要获得一个由表面扩散引发背应力的机理。......
2025-09-29
相关推荐